中国粉体网讯 在热管理领域,陶瓷材料由于普遍具有较高的导热系数,一直是热门材料,目前最火的应用有热界面材料中的陶瓷导热填料以及陶瓷基板。令人不解的是,碳化硅作为应用最广泛的陶瓷材料之一,明明拥有很高的热导率,却并没有在导热填料和散热基板领域实现广泛的应用,而氮化铝、氮化硅、氧化铝、氮化硼等陶瓷材料却混的风生水起。
01.碳化硅有很高的导热性能
SiC晶体的主要结构基本单元是Si原子和C原子通过sp3 共价键结合在一起形成的正四面体。这些原子堆积成两个主配位四面体SiC4 和CSi4 结构,其中四个C或Si原子连接到一个中心Si或C原子上。这些四面体通过其角连接紧密堆积形成的结构称为多型体,其在平行堆积平面的维度上的堆积顺序相似,但在垂直堆积平面的维度上的堆叠顺序则有所不同。典型的SiC多型体结构有3C、4H、6H和15R-SiC等(其中数字表示多型体结构的层数,字母表示晶格的对称性,如C:立方体;H:六角形;R:菱面体)。
3C-SiC与4H、6H-SiC的性能参数
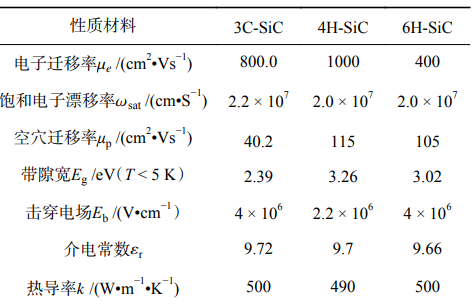
碳化硅的晶体结构赋予了其特殊的物理性质和热学性质,其理论导热率可以达到490W•m−1•K−1,在非金属材料中已属佼佼者。国外伊利诺伊大学的研究人员发现立方碳化硅(3C-SiC)块状晶体的导热系数仅次于金刚石单晶。

即便达不到单晶490W/(m·K)的导热上限,碳化硅颗粒作为导热填料热导率也能达到80~120W/(m·K),碳化硅陶瓷的热导率最高也能达到270W/(m·K),从导热系数看,其导热性能完全满足要求甚至是领先其他的陶瓷材料,那究竟因为什么而较少用于导热填料和散热基板方面呢?
02.导热填料方面,都是它惹的祸!
我们知道热界面材料主要是一类聚合物复合材料,以聚合物为基体,与高导热填料共混形成,由于聚合物的热导率很低,所以复合材料导热率的提升主要依靠导热填料的作用。
需要注意的是,绝缘材料中引入无机粒子会严重改变材料的电阻和击穿强度。无机粒子与材料本体之间的电导率和介电常数相差越大,高导热绝缘材料在应用过程中内部电场畸变越强烈,电场高度集中致使材料击穿强度降低。因此,制备高导热复合绝缘材料时,应当选取电绝缘性能优良、低介电常数和低损耗的与聚合物本体电学性能相近的无机粒子作为导热填料。
常用陶瓷材料性能
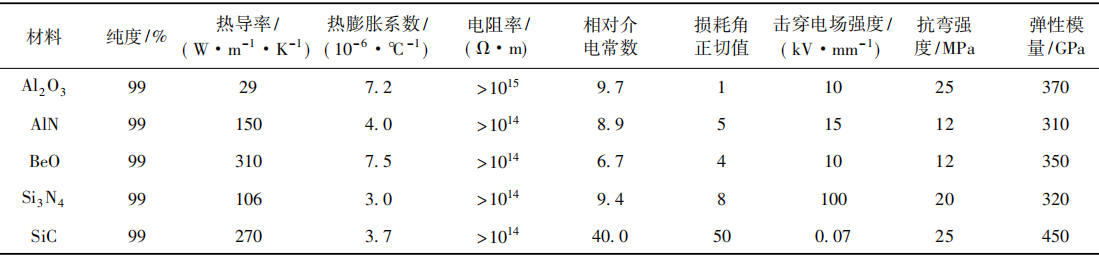
SiC的介电性能较差,采用SiC作为导热填料不可避免会导致复合材料介电性能的弱化,因而在高绝缘聚合物复合材料中的应用受到了一定的限制。
当前,氧化铝、氮化铝、氮化硼是主要的陶瓷填料。
虽然与其他颗粒相比,氧化铝本征热导率较低,但其具有较低的成本仍得到了广泛的研究与应用。
与其他导热绝缘填料相比,氮化铝粒子由于具有高导热系数(理论热导率为320W/(m·K))、高电阻率(电阻率大于1014Ω·m)、较低的介电常数和介电损耗、低热膨胀系数(4.4×10-6K-1,与硅相近)和无毒等一系列优良特性而受到广泛研究,成为导热复合材料的的理想填料。

六方氮化硼
六方氮化硼是目前最受关注的陶瓷填料,它拥有类似于石墨的层状结构,不仅热导率较高,而且拥有优异的绝缘性能(介电常数约为4.0,电阻率约为1015Ω·cm),是目前为止最理想的绝缘导热填料。
03.陶瓷基板方面,还是它惹的祸!
陶瓷材料本身具有热导率高、耐热性好、高绝缘、高强度、与芯片材料热匹配等性能,非常适合作为功率器件封装基板,目前已在半导体照明、激光与光通信、航空航天、汽车电子、深海钻探等领域得到广泛应用。
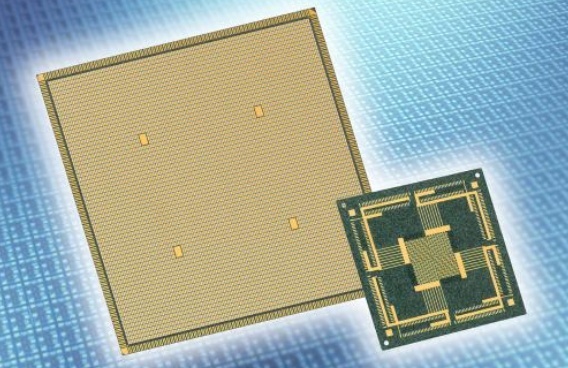
作为封装基板,要求陶瓷基片材料具有如下性能:
(1)热导率高,满足器件散热需求;
(2)耐热性好,满足功率器件高温(大于200°C)应用需求;
(3)热膨胀系数匹配,与芯片材料热膨胀系数匹配,降低封装热应力;
(4)介电常数小,高频特性好,降低器件信号传输时间,提高信号传输速率;
(5)机械强度高,满足器件封装与应用过程中力学性能要求;
(6)耐腐蚀性好,能够耐受强酸、强碱、沸水、有机溶液等侵蚀;
(7)结构致密,满足电子器件气密封装需求;
(8)其他性能要求,如对于光电器件应用,还对陶瓷基片材料颜色、反光率等提出了要求。

碳化硅基片
看得出来,像导热填料一样,陶瓷基板同样对材料的介电性能有一定的要求,相对于其它陶瓷材料而言,碳化硅陶瓷相对介电常数为40,是AlN陶瓷的4倍,会导致信号延迟,影响产品的可靠性,限制了其高频应用。此外,其不良的绝缘耐压性也阻碍了其在散热基板领域的应用。
陶瓷基板的性能参数
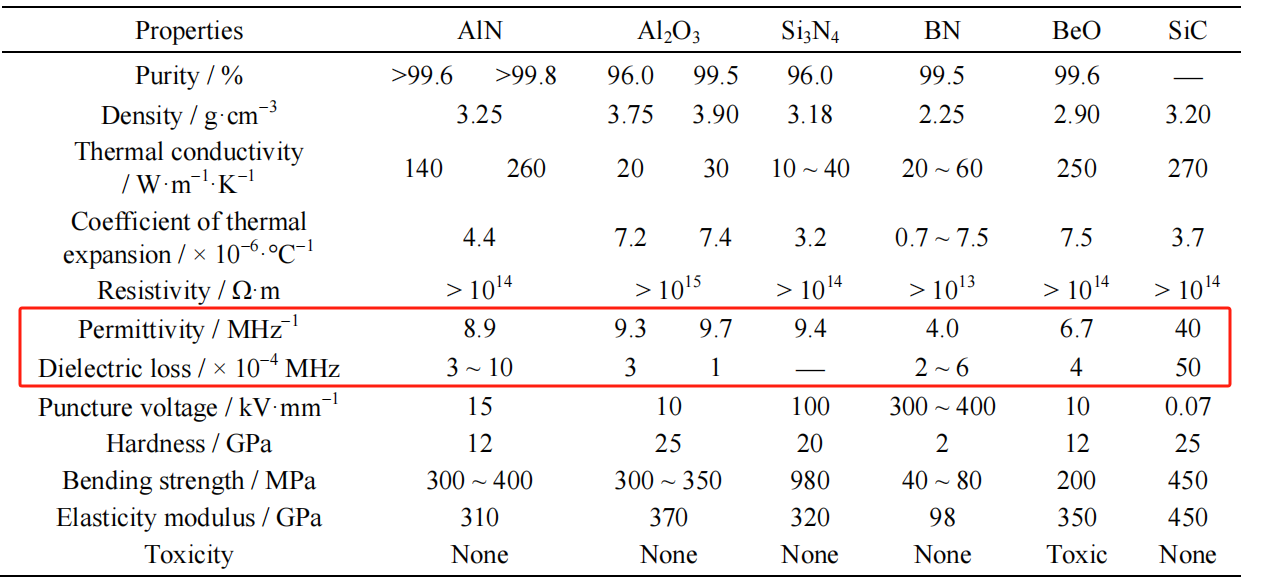
目前,常用电子封装陶瓷基板材料包括氧化铝、氮化铝、氮化硅、氧化铍等。
氧化铝陶瓷因价格较低、稳定性好、绝缘性和机械性能较好,而且工艺技术纯熟,是目前应用最为广泛的一种陶瓷基板材料,但是Al2O3陶瓷的热导率较低。
BeO陶瓷是目前较为常用的高导热陶瓷基板材料,综合性能良好,能够满足较高的电子封装要求,但是BeO粉末有剧毒,大量吸入人体后将导致急性肺炎,长期吸入会引起慢性铍肺病,这大大限制了它的应用。
相比之下,氮化铝陶瓷的各项性能优异,尤其是高热导率的特点,其理论热导率可达320W/(m·K),其商用产品热导率一般为180W/(m·K)~260W/(m·K),使其能够用于高功率、高引线和大尺寸芯片封装基板材料。
与其他陶瓷材料相比,Si3N4陶瓷材料具有明显的综合优势,尤其是在高温条件下氮化硅陶瓷材料表现出的耐高温性能、对金属的化学惰性、超高的硬度和断裂韧性等力学性能。Si3N4陶瓷的抗弯强度、断裂韧性都可达到AlN的2倍以上,特别是在材料可靠性上,Si3N4陶瓷基板具有其他材料无法比拟的优势是目前综合性能最好的陶瓷基板材料。
小结
话又说回来,碳化硅只是在导热填料和散热基板方面应用相对较少,在其它导热领域仍能呼风唤雨,例如:在高温领域,依靠优异的高温物理特性,碳化硅陶瓷可用于工业窑炉的横梁、辊棒等,在承担结构支撑的同时,凭借其良好的导热性能还能使窑炉更加节能;在加热与热交换工业领域,碳化硅陶瓷可用于喷火嘴,换热器等。
参考来源:
[1]江汉文等.碳化硅在导热材料中的应用及其最新研究进展
[2]杨达伟等.热界面用导热绝缘陶瓷填料的研究进展
[3]程浩等.电子封装陶瓷基板
[4]杜伯学等.高导热聚合物基复合材料研究进展
[5]中国粉体网
(中国粉体网/山川)
注:图片非商业用途,存在侵权告知删除






















