中国粉体网讯 在去年,玻璃基板作为封装环节的关键材料,仿佛一夜之间火了起来,成为半导体行业的新热点和新趋势。
有报道称英伟达的最新产品GB200采用的先进封装工艺将使用玻璃基板,同时,英特尔、三星、AMD、苹果等大厂都表示将导入或探索玻璃基板芯片封装技术。
为何芯片巨头都青睐玻璃基板?
封装基板主要利用材料本身具有的高热导率,将热量从芯片 (热源) 导出,实现与外界环境的热交换。
在目前的封装基板材料中,有机基板具有质量轻、可实现复杂电路设计、工艺流程简单、生产成本低等优点,但有机基板的高温热稳定性差,易受高温影响而变形;陶瓷基板的介电性能稳定,机械性能好,能满足集成电路的需求,但制造成本较高,且不适用于对轻量化有需求的应用场景。
出于制程工艺的迈进,芯片大厂们认为,陶瓷和有机基板将在未来几年达到其能力的极限。比如英特尔表示,到本世纪末,半导体行业使用有机材料在硅封装上扩展晶体管的能力将达到极限。
而如果芯片改用玻璃基板后将大幅提高电路板能承受的温度,使芯片在更高温度下工作,并在更长时间内维持最高性能。此外,玻璃基板具有扁平特性,能进行更精确雕刻,使元件间距离更近,增加任何给定尺寸内的电路密度。
玻璃基板在机械和电气性能方面也很出色,在制造超大型芯片时也不像有机基板那么不理想。这些基板可容纳的功率和数据连接数量是当今有机基板的10倍。这对于服务于数据人工智能(AI)和高性能计算(HPC)应用的大型芯片至关重要。所以玻璃基板的发展,对于目前芯片来说有着很重大的意义,至少在工艺发展难度和成本更高的时候,玻璃基板的发展会更现实。
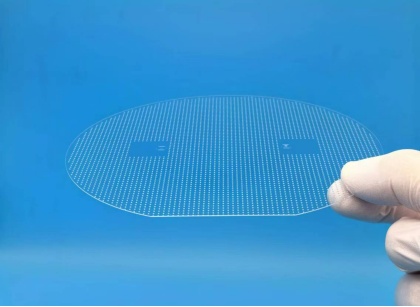
图片来源:中科岛晶
此外,随着芯片3D封装技术的发展,硅通孔(TSV)技术和玻璃通孔(TGV)技术相继得到应用。其中TGV技术全称为玻璃基微米级巨量互通技术,通过玻璃材料和孔加工技术实现的高品质TGV,可以实现数据中心、5G通信网络和IoT设备等各种市场的设备小型化,并实现高密度封装和GHz速度的数据处理,同时由于玻璃基板具有更优的散热性,有助于降低功耗,其在高算力数据中心服务器等领域有一定应用空间。TGV有望成为下一代半导体封装基板材料的技术解决方案,在TGV技术中,玻璃基板可提供高密度电气互连的解决方案。
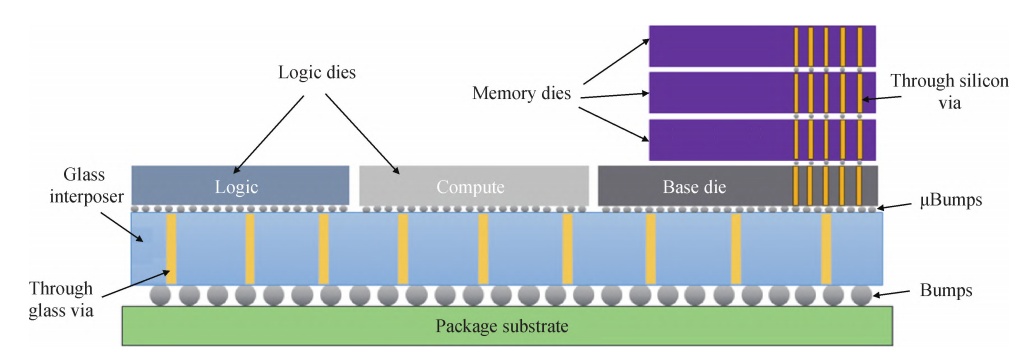
芯片3D封装结构示意图
目前业内的共识是,使用玻璃基板已经成为先进封装的一个趋势,但目前还存在一些技术和成本上的挑战。接下来,芯片企业与玻璃处理设备以及材料供应商需通过密切合作,建立一个可行的商业生产生态系统,加速推进该技术的商业化应用。
为此,中国粉体网特建“玻璃基板TGV技术交流群”,以期加强玻璃基板产业上下游交流,共同探讨学习产业技术,共同促进行业发展。

(中国粉体网/山川)
注:图片非商业用途,存在侵权告知删除


















